
トップページ > CAE ソリューション > Nitride MOVPE-database > GaN解析実績①
MOVPE-Database Menu
解析事例
- GaN フルスペックモデル
解析実績 ① - GaN フルスペックモデル
解析実績 ② - GaN フルスペックモデル
活用事例 - AlN, AlGaN フルスペック
モデル解析実績 ① - InGaN フルスペックモデル
活用事例
窒化物MOVPE成長 反応データベース

GaN 成長(フルスペックモデル)の解析実績①
公表論文 (本事例紹介の内容は、下記の論文より引用しています。)
- 平子晃, 小磯沙織, 草部一秀, 大川和宏, 信学技報, 105巻, 90号, 85 (2005).
- A. Hirako, S. Koiso, K. Ohkawa, physica status solidi (a), 203, 1716 (2006).
GaN 成長モデル(フルスペックモデル)を利用した事例を紹介します。
1. TMGa/NH3/H2系の反応経路の概略図
図1に、GaN 成長モデルに含まれる反応経路の概略を示しています。①アダクト分子形成に関連する反応経路、②重合分子形成に関連する反応経路、③TMGa の熱分解反応および、NH3, CH3, H に関連する反応経路によって構成されています。
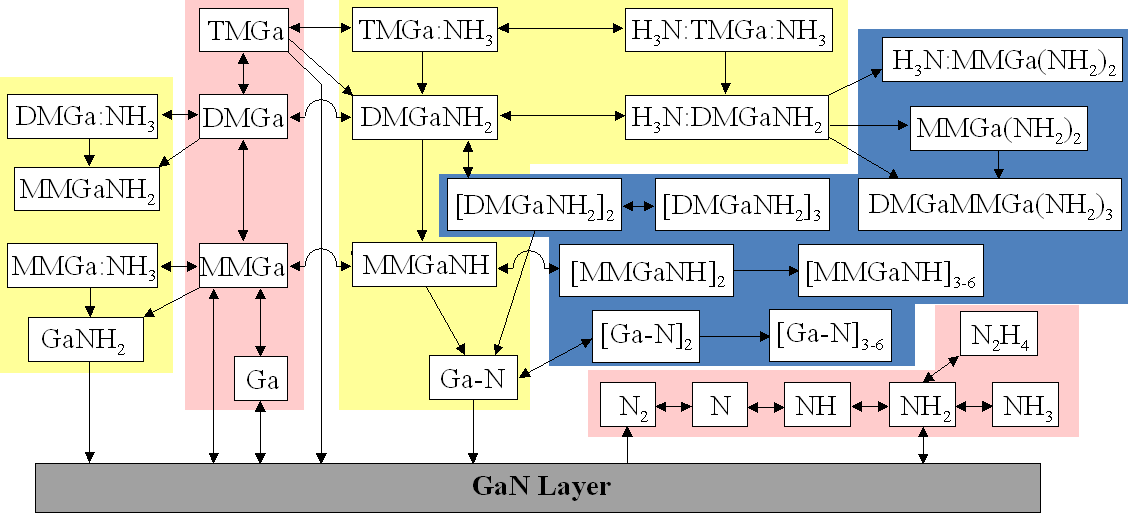
図1 GaN 結晶の MOVPE 成長下における TMGa/NH3/H2化学反応系の概略図
※ クリックで拡大表示
2. 計算モデル
使用データベース:GaN成長(フルスペック)モデル・熱解析データ計算ソルバー:CFD-ACE+
計算対象は成長実験で使用されている水平型反応炉とし、図2 のように2次元でモデル化しています。
原料ガス流量は、TMGa = 30 μmol/min, NH3 = 1 slm, H2 = 5 slm で、V/III比 = 1490。成長圧力は、104 kPa を指定しています。反応モデルは、図1 で示されるフルスペックの GaN 成長反応モデルを用いています。また、精度の高い炉内の温度分布を得るために、熱解析データに含まれる波長依存の光学物性および、基板/トレイ、トレイ/サセプタにおける接触熱抵抗を考慮しています。
3. 成長速度の温度依存性を計算
サセプタ温度が 300~1400 K の範囲で計算を行い、成長速度の温度依存性を確認しました。
図3 のGa-N 重合反応ありの計算結果(赤線)は750 K より低い温度での反応律速、750~1300K の供給律速、そして1300 K 以上の蒸発律速の各成長段階を再現しており、実験値とよく一致しています。また、図1 の反応経路における重合反応を除いた計算によって得られる成長速度(青線)の上昇は、GaN 成長に必要な原料が重合反応によって失われていることを示唆しています。
4. サセプタおよび石英壁面の GaN 成長速度分布
サセプタ温度を 1300 K とした時の炉内温度分布および、成長速度分布を解析しました。サセプタ上方の天井部の石英温度は、ふく射により600 K 以上に上昇しており、天井部において GaN の付着が生じることが予想されます。基板表面における GaN 成長速度の平均は、1.8μm/h であり、実験値をよく再現しています。

図4 a)温度分布、b)天井部、および c)基板と基板前後の石英壁面における成長速度分布
※ クリックで拡大表示